宽禁带半导体氮化镓(GaN)相对于硅(Si)具有禁带宽度更大、击穿场强更高、电子迁移率更高、电子饱和漂移速度更快的特点。得益于这些优异的材料特性,氮化镓电子器件已经广泛应用于消费电子快充、高频通信、雷达系统等领域,并有望扩展至数据中心、汽车电子等领域。
基于氮化镓材料的高电子迁移率晶体管(High Electron Mobility Transistor, HEMT)通常为耗尽型器件,即在无外界栅极控制电压的情况下呈现导通状态。然而,在电力电子变换器中使用耗尽型器件时,需要施加负向的电压来关断器件,这会增加驱动电路的复杂性。同时在栅极失效的情况下,会带来器件和系统短路的风险。与之相反,常关(Normally-off)的氮化镓增强型HEMT器件可减少驱动电路复杂度,并简化保护方案,是目前氮化镓领域的一项研究热点。
邹新波课题组此前对含p-GaN帽的增强型HEMT器件进行了多项研究,包括少数载流子陷阱[APL 2022]、宽温度范围动态特性[IEEE TED 2022]、高性能低频噪声放大器[IEEE EDL 2023]。与需要额外p-GaN外延层的HEMT器件相比,基于凹栅结构的增强型MOSHEMT(Metal Oxide Semiconductor HEMT)器件对外延层的要求较低,可通过成熟的AlGaN/GaN外延结构进行制备。此外,凹栅MOSHEMT可以通过优化介质层提高器件栅极的耐压能力,达到更大的栅极驱动能力;该凹栅结构还有利于实现更好的栅极控制能力,可进一步改善增强型器件的截止频率和跨导。
目前,凹栅结构MOSHEMT器件的性能及可靠性常常受限于刻蚀过程中引入的刻蚀损伤及界面态。这是因为凹栅刻蚀过程中通常采用感应耦合等离子体-反应离子刻蚀(ICP-RIE)作为材料去除工艺。然而,在该方法中,由于带电离子束的作用,刻蚀过程中常伴随着由电荷积累或真空紫外线辐射引起的损伤和缺陷,从而导致器件性能下降。
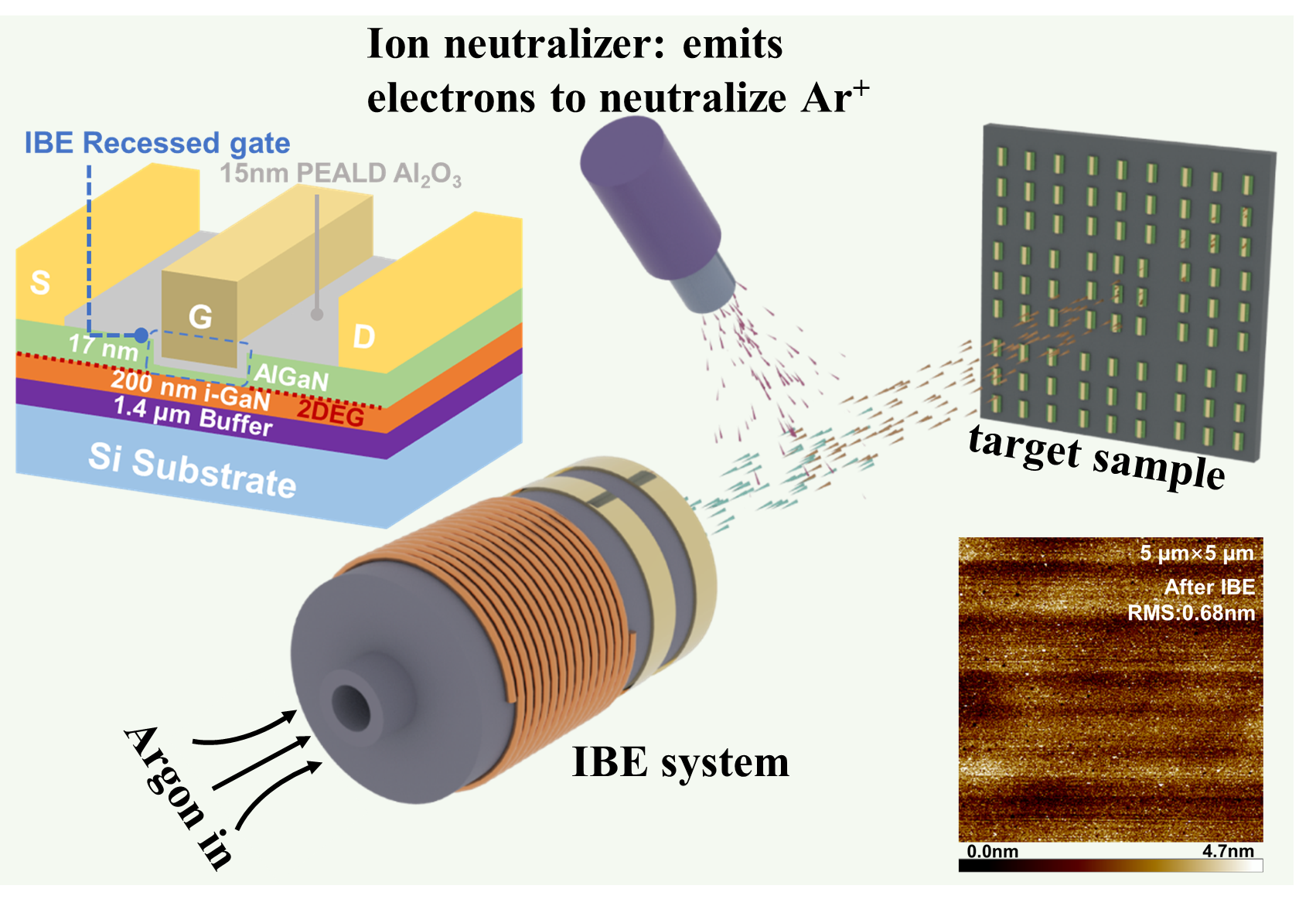
图1. 中性粒子束刻蚀技术示意图
为了实现高质量的凹栅结构,推动增强型GaN电子器件的性能提升,邹新波课题组创新地采用中性粒子束刻蚀技术(Ion Beam Etching, IBE)制备了凹栅增强型MOSHEMT器件。该刻蚀工艺的原理如图1所示。首先,氩气在射频线圈的作用下生成氩等离子体。这些氩等离子体在直流电场中获得较高的动能,并通过离子中和器后变成电中性。中性的氩粒子随后轰击样品表面,发生能量和动量的交换,从而实现刻蚀目标材料的目的。电中性可以消除基片表面对粒子束的排斥作用,从而确保粒子束的直线轨迹,因此凹栅的刻蚀轮廓能够保持极佳的平整度。通过该技术刻蚀后的正方形区域(25平方微米)的表面粗糙度仅为0.68纳米。若将其放大至一个足球场的大小,则表面的起伏仅为1.1厘米。
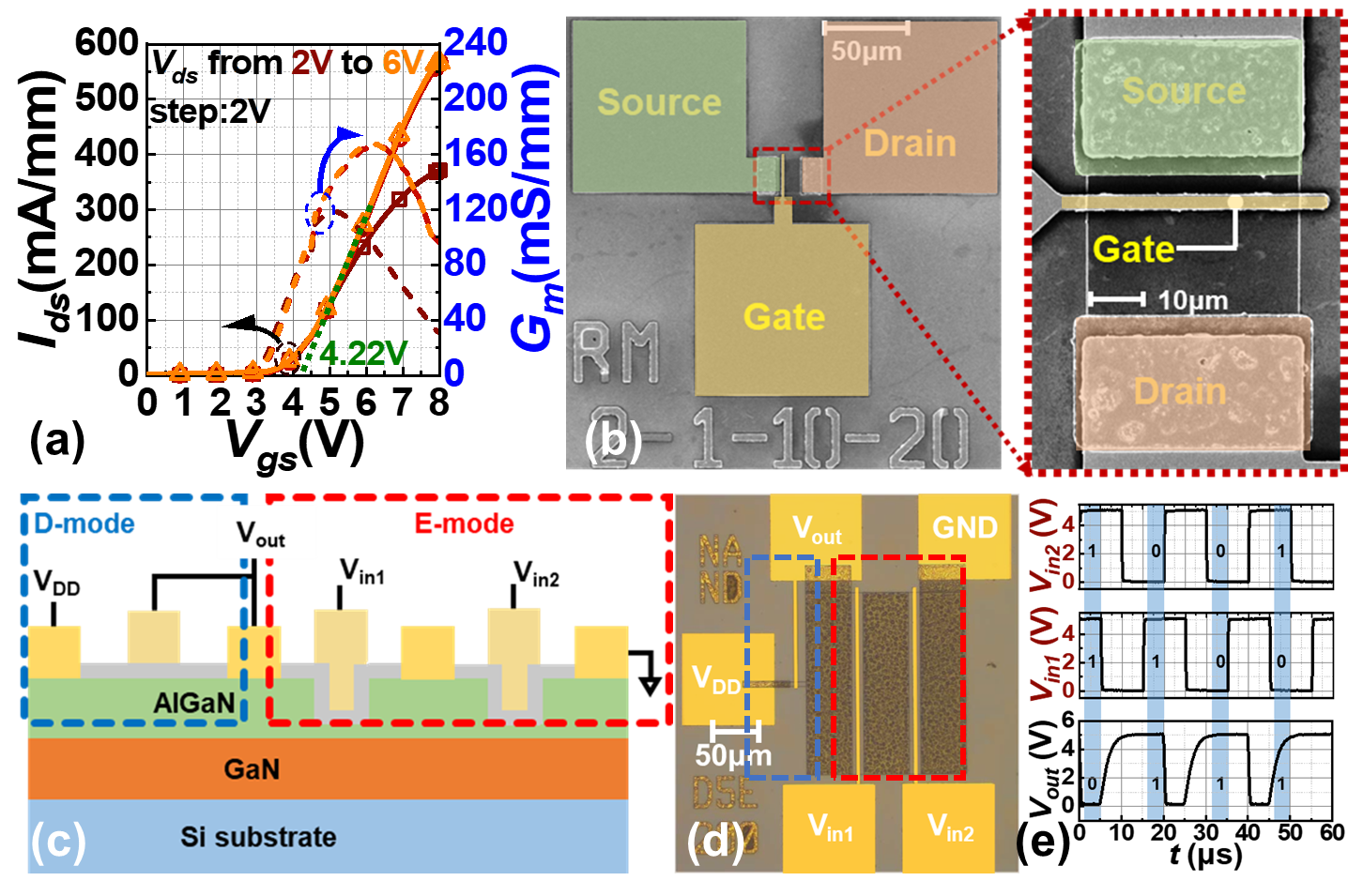
图2. (a) 基于中性粒子束刻蚀技术的凹栅结构氮化镓MOSHEMT转移特性与跨导特性曲线;(b) 该器件在扫描电子显微镜下的形貌图。(c) 基于中性粒子束刻蚀技术的片上集成与非门结构示意图;(d) 对应与非门的光学显微镜图片;(e) 对应与非门的输入与输出波形。
利用该技术,邹新波课题组成功制备了性能优异的增强型晶体管器件。该器件不仅具有较高的阈值电压(4.22V),还表现出优异的电流特性(饱和电流为545 mA/mm,特定导通电阻为0.18 mΩ∙cm2),其Baliga品质因子高达567 MW/cm2。此外,基于该技术平台,邹新波课题组还在同一外延片上同时实现耗尽型器件与增强型器件。基于这两类器件的单片集成已完整地展示了数字逻辑的基本单元,为发展全氮化镓集成的功率电路模块提供了坚实的基础。
研究成果以“545-mA/mm E-mode Recessed-Gate GaN MOSHEMT (Vth > 4V) by Ion Beam Etching”为题发表在微电子器件领域国际知名期刊IEEE Electron Device Letters上,课题组2022级硕士研究生高涵与2019级博士研究生顾怡恬为论文第一作者,信息学院邹新波教授为论文通讯作者,上海科技大学为论文的第一完成单位。该研究得到了上海科技大学量子器件中心(SQDL平台)的大力支持和帮助。
相关论文链接:
'545 mA/mm E-mode Recessed-Gate GaN MOSHEMT (Vth > 4V) by Ion Beam Etching', IEEE Electron Device Letters, April. 2024
https://ieeexplore.ieee.org/document/10495344




 沪公网安备 31011502006855号
沪公网安备 31011502006855号


